商机详情 -
非标无功老化测试设备现货直发
SiC宽禁带半导体功率器件更高的开关频率,可以降低无源器件的重量,占用的封装体积也更小,因此可以提高功率器件的功率密度,同时SiC器件具有更高的热导率,可以更高效的把芯片耗散热排出。然而,SiC器件越来越高的电压等级和开关速度也给器件封装带来巨大的挑战。目前现有封装技术的不适配是摆在高压SiC器件应用面前的一道屏障。SiC芯片尺寸小,厚度更薄,而电压等级提高,需要特别关注封装中涉及芯片、基板以及输出端子等薄弱点的电气绝缘问题,如10kVSiCMOSFET的芯片厚度只有100μm,平均电场强度达到100kV/mm,而对于1.7kV的SiIGBT,芯片厚度为210μm,而平均电场强度只有8.1kV/mm。动态测试IGBT自动化设备可分析和优化器件在过温和过压情况下的性能。非标无功老化测试设备现货直发
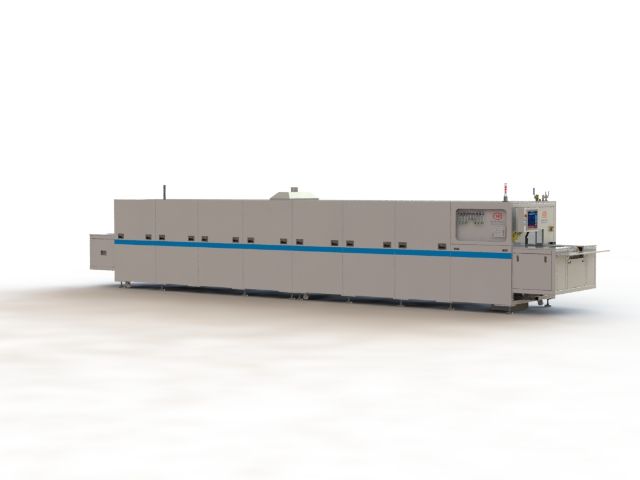
对于AMB基板,由于中间有1层活性钎料,其中的Ti元素对附着力起到关键因素,Ti元素与AlN基板反应生成TiN,可以提升金属层的附着力。对于DBC基板,在覆铜过程中Cu箔与微量氧气生成Cu2O,而Cu2O可以与金属Cu形成共晶组织。AlN基板在覆Cu箔之前通常需要对其进行预氧化处理,形成几个μm厚度的Al2O3层,Cu2O与Al2O3可以在高温下生成CuAlO2化合物,因此AlN基板与覆Cu层具有很好的界面结合。TFC基板的附着力主要由浆料内部的玻璃成分决定,高温烧结过程中玻璃软化并与陶瓷基板润湿产生结合,此外软化的玻璃还可以锚接铜粉烧结形成的金属化层,从而使金属化层与陶瓷基板牢固结合。对于DPC陶瓷基板,电镀Cu层与AlN基板之间只有一层Ti薄膜层,该薄膜与陶瓷基板只有物理结合,因此金属层结合力较低。江苏DBC底板贴装机行价通过功能测试,IGBT自动化设备能够检验产品的性能,确保符合工厂标准。

基于面互连原理,SKiN芯片连接采用扩散银颗粒烧结取代传统键合线封装中的焊料连接,芯片烧结到DBC基板上,采用两层柔性板上的可烧结铜箔连接芯片上表面和基板,柔性板的下金属层成为功率侧,承载高功率负载电流,根据材料(铝或者铜)以及所需的电流,该金属层的厚度在100μm范围内更合适。柔性板的上下金属层彼此绝缘,上金属层为逻辑侧,只需相对较薄的厚度(30μm),主要承载栅极、辅助和感应信号。柔性板上开有通孔,可以将芯片的栅极信号引出到柔性板的逻辑侧。不同于键合线的点互连,该柔性铜箔与芯片电极之间可以达到85%的接触,而传统键合线与芯片间的接触只有21%,增大接触面积和金属层厚度可以改善传热,并且可很大程度上提高器件的功率循环能力。
伴随着电网规模越来越大,电压等级越来越高,电力系统朝着更加智能化方向发展,高压、大功率和高开关速度要求功率器件承担的功能也更加多样化,工作环境更加恶劣,在此背景下,除芯片自身需具有较高的处理能力外,器件封装结构已成为限制器件整体性能的关键。而传统的封装或受到材料性能的限制或因其自身结构设计不能适应高压大电流高开关速度应用所带来的高温和高散热要求。为保证器件在高压高功率工况下的安全稳定运行,开发结构紧凑、设计简单和高效散热的新型功率器件,成为未来电力系统用功率器件发展的必然要求。功率端子键合环节中,IGBT自动化设备能够实现端子的稳固连接。

IGBR是具有防潮功能的大功率背接触式电阻器,可实现超高额定功率,具有适用于混合组件的微型外壳尺寸。IGBR电阻器具有高额定功率、单一引线接合组装的特性,外壳尺寸从0202到0808不等。典型应用于功率转换器(第三代SiCMOSFET)的栅极电阻器、大功率应用和替代能源等领域。IGBR是节省电源模块空间的完美部件。为什么IGBT模块中需要栅极电阻器?1.通过限制电流影响开关速度;2.限制栅极驱动路径中的噪声;3.限制寄生电感和电容;4.限制对栅极进行充电和放电的电流;5.限制峰值栅极电流以保护驱动器输出级;6.耗散栅极回路中的功率;7.影响开关损耗并防止栅极振荡。动态测试IGBT自动化设备能够评估器件在瞬态工况下的性能。静态测试外壳组装兼容设备厂家供应
IGBT自动化设备实现了功率半导体器件封装过程中的自动化操作和控制。非标无功老化测试设备现货直发
封装结构双面散热:随着器件功率密度的不断提高,器件封装的热管理变得愈加关键。基于上述总结与分析,优化器件封装散热路径是解决高压大电流高功率密度条件下功率器件散热、降低芯片结温的有效方案。键合线连接器件无法将芯片上表面作为散热通路,采用无键合线封装,充分利用芯片上表面进行散热,热量从芯片上下表面两个路径传递,可增强器件的散热能力,降低芯片结温,提高器件的热性能。为利用芯片上表面散热,研究人员提出了press-pack封装方法,该方法利用压力接触取代键合线和焊料,可降低杂散电感且具有更高的可靠性。该封装使器件具有双面散热的能力。非标无功老化测试设备现货直发