商机详情 -
静态测试真空炉制造商
要实现双面散热,需要对芯片的两个表面实现面连接,这样才能在芯片两侧形成两个平面,实现两个热通路。另一种实现面连接的方式是在芯片的两侧均采用DBC基板连接。通过采用“Planar-bond-all,(PBA)”的功率模块封装方法可以在芯片的上表面实现大面积键合平面互连。芯片正面朝上/朝下键合在两个DBC之间,两个铜制热沉直接连接在两侧DBC的外表面上。封装时将DBC基板、芯片、垫片、键合材料、功率端子等组装在夹具中,然后同时加热形成键合。双侧平面键合可以使封装的上下两个表面都成为散热通路。此外,热沉与DBC基板直接连接进一步降低了封装热阻。自动化设备的使用提高了IGBT模块封装工艺的一致性和可靠性。静态测试真空炉制造商

在2.5D结构中,不同的功率芯片被焊接在同一块衬底上,而芯片间的互连通过增加的一层转接板中的金属连线实现,转接板与功率芯片靠得很近,需要使用耐高温的材料,低温共烧陶瓷(LTCC)转接板常被用于该结构,下图为一种2.5D模块封装结构。而在3D模块封装结构中,两块功率芯片或者功率芯片和驱动电路通过金属通孔或凸块实现垂直互连,是一种利用紧压工艺(Press-Pack)实现的3D模块封装,这种紧压工艺采用直接接触的方式而不是引线键合或者焊接方式实现金属和芯片间的互连,该结构包含3层导电导热的平板,平板间放置功率芯片,平板的尺寸由互连的芯片尺寸以及芯片表面需要互连的版图结构确定,整个结构的厚度一般小于5mm。非标超声波键合机厂家直销IGBT自动化设备实现了功率半导体器件封装过程中的自动化操作和控制。
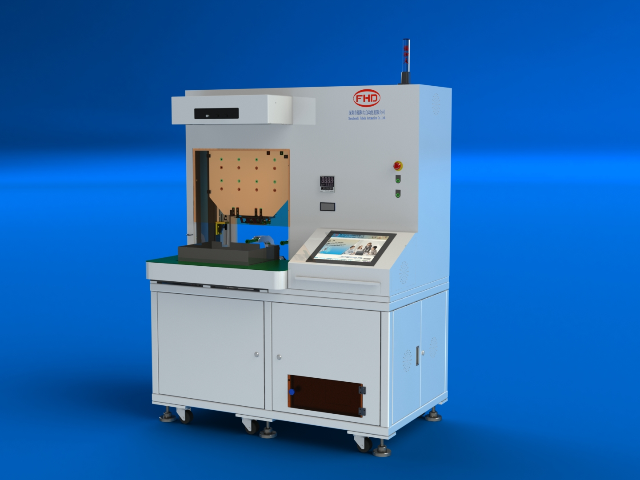
高电压等级的SiC器件电场强度达到Si器件的10倍以上。因此,针对高压功率器件的封装需要特殊的设计以满足高压绝缘的要求,如需要开发在高电场环境下仍具有高电压绝缘强度和稳定性的绝缘灌封材料,以隔离水汽、污染物等外界环境。另外,针对灌封过程存在气泡的问题,现有灌封工艺还需要进一步完善。SiC功率器件可以承受更高的工作结温,降低对外部冷却器件的要求,缩小封装器件的体积,使得封装器件更加轻质高效。然而,缺乏适合的高温封装技术体系成为限制SiC器件充分发挥其潜力的至大因素,特别是对于高压大电流应用需求的系统。对于传统硅基功率器件,单热管理部分就占到整个器件封装系统成本的三分之一以上。但随着SiC技术的进步,SiC器件的高温运行能力所带来的优势足以弥补现阶段SiC的成本问题。
汽车IGBT模块测试标准下功率循环和温度循环作为表示的耐久测试,要求极为严格,例如功率循环次数可能从几万次到十万次不等。主要目的是测试键合线、焊接层等机械连接层的耐久情况。测试时的失效机理主要是,芯片、键合线、DBC、焊料等的热膨胀系数不一致,导致键合线脱落、断裂,芯片焊层分离,以及焊料老化等。随着国内新能源汽车产业的快速发展,产业链上游大有逐步完成国产替代,甚至带领世界的趋势,诸如整车品牌、动力电池、电池材料等等已经走得比较靠前,而汽车电控IGBT模块是新能源汽车主要的功率器件。自动化设备的应用使IGBT模块的封装工艺更加智能化和高效化。

由CMC制成的垫片可以传导电流、传递热量、保证电气绝缘距离,并具有与芯片和基板相匹配的可调节热膨胀系数(CTE)。交错平面封装方法通过增加相邻芯片间的距离来减小等效耦合热阻,拉长热耦合的传热路径,具有均匀且较小的热耦合效应。这种封装方式利用了3D封装结构灵活性的优势,增大传热距离,但没有增大功率模块的尺寸。具有低热耦合效应、更均匀的温度分布和出色的热性能。在相同的耗散热和散热条件下,与传统芯片布局封装模块至大结温155.8℃,封装内部至大温差12.3℃相比,交错布局封装至大结温为135.2℃,封装内部至大温差只3.4℃。显然,交错封装模块的温度分布更加均匀,可有效降低封装热阻和芯片间的热耦合不均匀程度。IGBT自动化设备的动态测试能够辅助优化器件的设计和生产工艺。非标超声波键合机厂家直销
功率端子键合环节中,IGBT自动化设备能够实现端子的稳固连接。静态测试真空炉制造商
目前商用的SiC肖特基二极管受限于传统塑料封装形式,其额定工作结温上限只能达到175℃。现有SiC器件的封装仍主要采用焊接封装,考虑到芯片绝缘和隔离外界环境的目的,封装模块内部灌封有完全覆盖芯片表面的热导率较低的硅凝胶,硅凝胶上层为空气,该封装形式也使得这种从上向下的热传导成为芯片产生热量的散热通道。为了充分利用SiC器件高结温的优势,发挥SiC器件的潜力,开发新的便于芯片散热的封装结构,为芯片封装提供高效的散热路径,达到降低芯片结温,提升器件整体性能的目的,非常有必要改进现有的传统功率器件封装技术,开发新型功率器件封装结构。由此,通过增加封装器件的散热路径来提高器件散热能力的方法也就很自然的被提出。静态测试真空炉制造商